NCT打破世界紀(jì)錄——氧化鎵器件性能提高3.2倍!
株式會(huì)社 Novel Crystal Technology (總部:埼玉縣狹山市,社長(zhǎng)倉(cāng)又朗人)在防衛(wèi)裝備廳安全保障技術(shù)研究推進(jìn)制度(JP004596)“反向 MOS 溝道型氧化鎵晶體管的研究開(kāi)發(fā)”項(xiàng)目中,成功開(kāi)發(fā)了功率品質(zhì)因數(shù)(PFOM)達(dá)到 1.23 GW/cm2 的氧化鎵垂直 MOS 晶體管(β-Ga2O3 MOSFET)。該 PFOM 值是 β-Ga2O3 FET 領(lǐng)域的世界最高值,是其他研究機(jī)構(gòu)發(fā)表的 β-Ga2O3 FET最高值的 3.2 倍。
該次研究在中高耐壓(0.6-10 kV)氧化鎵晶體管的開(kāi)發(fā)取得了重大進(jìn)展,將推動(dòng)功率電子技術(shù)的低成本化和高性能化。此外,未來(lái)有望通過(guò)提高工業(yè)用逆變器和電源等功率電子設(shè)備的效率并實(shí)現(xiàn)小型化,從而促進(jìn)電動(dòng)汽車(chē)、飛行汽車(chē)等電能的高效利用,以及太陽(yáng)能、風(fēng)能等可再生能源發(fā)電與電力系統(tǒng)并聯(lián)的高效電力轉(zhuǎn)換裝置的進(jìn)一步發(fā)展。關(guān)于本成果的詳細(xì)信息,將于 2025 年 3 月 15 日在第 72 屆應(yīng)用物理學(xué)會(huì)春季學(xué)術(shù)會(huì)議上以“通過(guò) β-Ga2O3 FinFET 實(shí)現(xiàn)功率 FOM 1.23 GW/cm2 的驗(yàn)證”為報(bào)告主題進(jìn)行發(fā)表。
1.概述
氧化鎵(β-Ga2O3)※1 作為一種可替代硅的高性能材料,與同樣在開(kāi)發(fā)中的碳化硅(SiC)※2 和氮化鎵(GaN)※3 相比,憑借其優(yōu)異的材料特性和低成本的晶體生長(zhǎng)方法,能夠制造出低損耗、低成本的功率器件※4。因此,β-Ga2O3 在家電、工業(yè)設(shè)備、電動(dòng)汽車(chē)、鐵路車(chē)輛、太陽(yáng)能發(fā)電、風(fēng)力發(fā)電等各種功率電子設(shè)備中的應(yīng)用備受期待。此外,由于其能夠?qū)崿F(xiàn)搭載電氣設(shè)備的小型化和高效化,國(guó)內(nèi)外企業(yè)和研究機(jī)構(gòu)也正在加速相關(guān)研究與開(kāi)發(fā)。
株式會(huì)社 Novel Crystal Technology 自 2019 年起,以實(shí)現(xiàn) β-Ga2O3 MOSFET 的產(chǎn)品化為目標(biāo),參與了防衛(wèi)裝備廳安全保障技術(shù)研究推進(jìn)制度的“10 kV 級(jí)氧化鎵溝槽 MOSFET 的研究開(kāi)發(fā)”和“反向 MOS 溝道型氧化鎵晶體管的研究開(kāi)發(fā)”項(xiàng)目。此次,通過(guò)在具有高耐壓 β-Ga2O3 漂移層的 MOSFET 柵極電極端部,設(shè)置由 Mg 離子注入形成的高電阻保護(hù)環(huán)結(jié)構(gòu)※5,成功實(shí)現(xiàn)了 β-Ga2O3 MOSFET 的功率品質(zhì)因數(shù) (PFOM)※6 的世界最高值 1.23 GW/cm2。這一開(kāi)發(fā)成果將推動(dòng)中高耐壓(0.6-10 kV)氧化鎵晶體管的開(kāi)發(fā),為功率電子技術(shù)的低成本化和高性能化帶來(lái)重大進(jìn)展。
2.研究成果
此前,NCT 對(duì)于 β-Ga2O3 MOSFET 的研發(fā)由于柵極電極端部的電場(chǎng)集中問(wèn)題,未能充分發(fā)揮其高絕緣擊穿電場(chǎng)強(qiáng)度(6~8 MV/cm)的優(yōu)勢(shì)。傳統(tǒng)功率半導(dǎo)體(如SiC、GaN)通常使用 p 型導(dǎo)電層※7緩解電場(chǎng)集中,但氧化鎵尚未建立成熟的 p 型導(dǎo)電層技術(shù),因此無(wú)法將同樣的方法應(yīng)用于氧化鎵。
為克服這一難題,我們采用了 Mg 離子注入※9的方式,在氧化鎵中形成深能級(jí)受主雜質(zhì)※8,并通過(guò)活化熱處理※10,構(gòu)建出高電阻防護(hù)環(huán)結(jié)構(gòu)。

圖 1 . β-Ga2O3 MOSFET 簡(jiǎn)要圖
圖1展示了本次開(kāi)發(fā)的 β-Ga2O3 MOSFET 的橫截面結(jié)構(gòu)和平面布局。該晶體管具備以下特點(diǎn):
?采用有利于低損耗、大電流的垂直器件結(jié)構(gòu)。
?具備多鰭式(Multi-Fin)結(jié)構(gòu)※11,可在無(wú)需 p 型導(dǎo)電層的情況下實(shí)現(xiàn)常閉(Normally-Off)特性;
?采用7.5 × 1015 cm-3 的施主濃度、55 µm 厚的高耐壓 Ga2O3 漂移層;
?在電極端部的 β-Ga2O3 區(qū)域引入 Mg 離子注入保護(hù)環(huán),有效緩解電場(chǎng)集中問(wèn)題。
本次試制的 β-Ga2O3 MOSFET 采用 0.2 µm 的 mesa 寬度、3.5 µm 的柵極長(zhǎng)度、70 µm 的鰭片長(zhǎng)度、5 µm的鰭片間距,包含 10 條鰭片(Fin)。
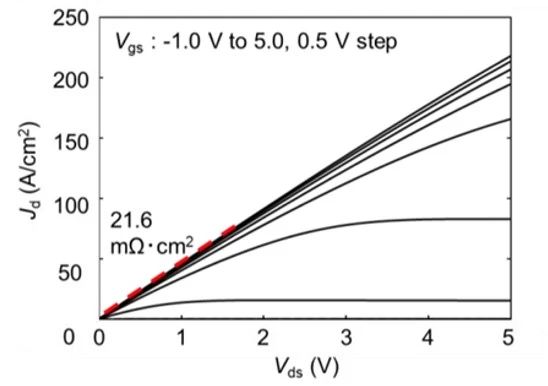
圖 2 . 漏極電流-電壓特性
圖 2 顯示了試做的 β-Ga2O3 MOSFET 的漏極電流-電壓特性。按源極面積(50 µm × 60 µm)歸一化的最大電流密度為 218 A/cm2 ,特性導(dǎo)通電阻為 21.6 mΩ·cm2 (Vgs = 5 V)。
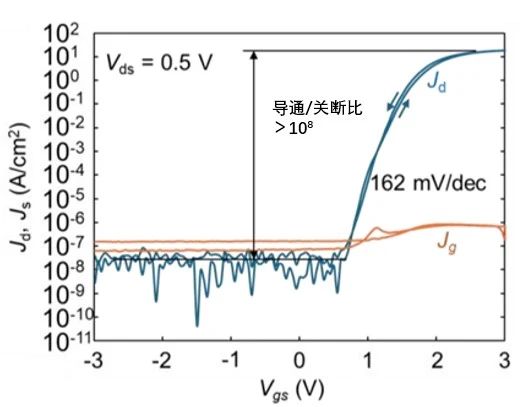
圖 3 . 漏極電流 · 柵極電流-柵極電壓特性
圖 3 所示漏極電流和柵極電流與柵極電壓的關(guān)系。漏極電流導(dǎo)通/關(guān)斷比提高了 8 位數(shù)以上,亞閾值系數(shù)※12 為 162 mV/decade,顯示出良好的晶體管特性。
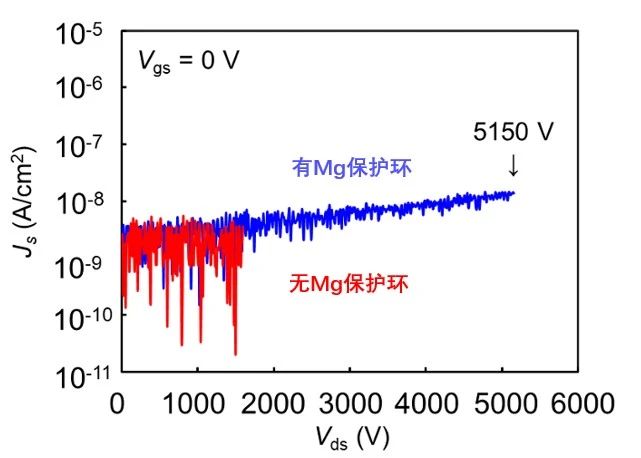
圖 4 . 晶體管耐壓波形
圖 4 顯示了在柵極和源極電壓固定為 0 V 時(shí)向漏極施加正電壓時(shí)的源極和柵極電流特性。通過(guò)采用 Mg 離子注入的保護(hù)環(huán)結(jié)構(gòu),擊穿電壓從之前的 1.6 kV 上升到 5.15 kV。保護(hù)環(huán)結(jié)構(gòu)前后,β-Ga2O3 漂移層中的最大電場(chǎng)強(qiáng)度估計(jì)分別為 2 MV/cm 和 3.72 MV/cm。研究人員認(rèn)為,Mg 保護(hù)環(huán)減輕了柵極邊緣的電場(chǎng)集中,使漂移層中的電場(chǎng)強(qiáng)度得以提高。
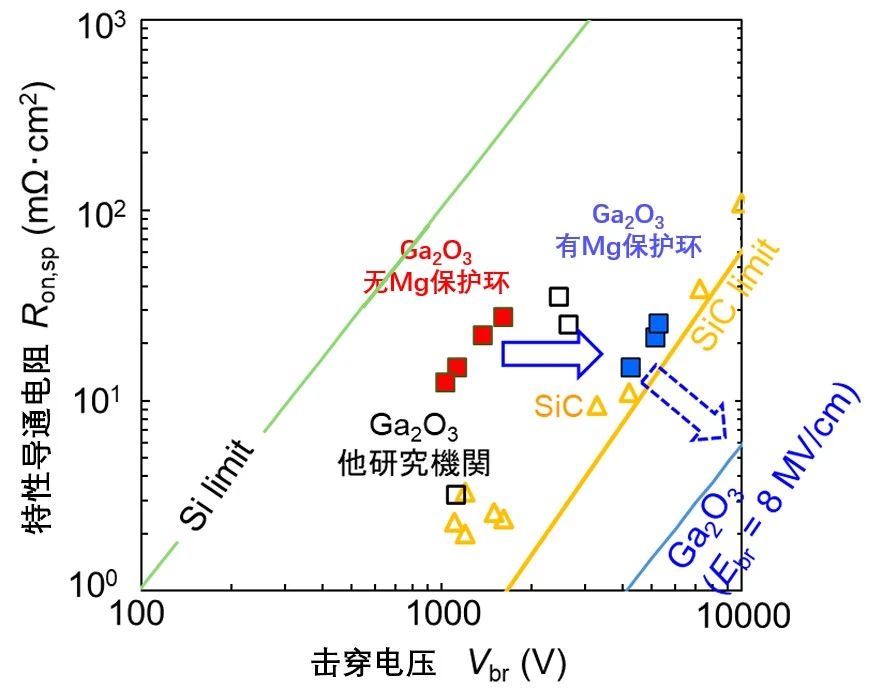
圖 5 . MOSFET 的特性導(dǎo)通電阻和擊穿電壓
圖 5 顯示了特性導(dǎo)通電阻(Ron,sp)與擊穿電壓(Vbr)之間的關(guān)系,后者是功率器件的性能指標(biāo)。通過(guò)在電極終止區(qū)將 Mg 離子注入 β-Ga2O3 而形成的保護(hù)環(huán)結(jié)構(gòu),擊穿電壓得到了明顯改善。因此,獲得了 1.23 GW/cm2 的良好 PFOM 值,比使用保護(hù)環(huán)前高出 13.3 倍。現(xiàn)在的 PFOM 值是全球 β-Ga2O3 FET 中的最高值,是其他研究機(jī)構(gòu)公布的 β-Ga2O3 FET 最高值的 3.2 倍。
3.未來(lái)展望
未來(lái),研究人員將進(jìn)一步優(yōu)化 β-Ga2O3 MOSFET的終端結(jié)構(gòu),包括引入 NiO 等異質(zhì) p 型半導(dǎo)體材料,進(jìn)一步緩解電極端部的電場(chǎng)集中問(wèn)題。通過(guò)這項(xiàng)技術(shù),希望充分發(fā)揮 β-Ga2O3 的高擊穿電場(chǎng)強(qiáng)度(6~8 MV/cm),實(shí)現(xiàn)超越 SiC 的高性能氧化鎵功率晶體管。
4.術(shù)語(yǔ)解釋
※1 氧化鎵(β-Ga2O3):Gallium Oxide,是鎵和氧的化合物,一種寬禁帶半導(dǎo)體材料。
※2 碳化硅(SiC):是硅和碳的化合物,一種寬禁帶半導(dǎo)體材料
※3 氮化鎵(GaN):是鎵和氮的化合物,一種寬禁帶半導(dǎo)體材料。
※4 功率器件:能控制高電壓、大電流的半導(dǎo)體元件,如逆變器等。
※5 保護(hù)環(huán)結(jié)構(gòu):是一種通過(guò)在電極終端電場(chǎng)容易集中的區(qū)域設(shè)置與漂移層導(dǎo)電類(lèi)型不同的導(dǎo)電層,來(lái)橫向擴(kuò)展等電位面并緩解電場(chǎng)集中的一種結(jié)構(gòu)。
※6 功率品質(zhì)因數(shù)(PFOM):計(jì)算公式為Vbr2/Ron,sp;用于評(píng)估功率器件性能的重要指標(biāo),數(shù)值越大性能越為優(yōu)秀。
※7 p型導(dǎo)電層:導(dǎo)電半導(dǎo)體中的載流粒子為空穴而非電子的半導(dǎo)體層。
※8 受主雜質(zhì):受主雜質(zhì)是指能夠捕獲電子并帶負(fù)電的半導(dǎo)體中的雜質(zhì)。通常情況下,受主雜質(zhì)通過(guò)捕獲電子在半導(dǎo)體內(nèi)產(chǎn)生空穴,從而使半導(dǎo)體成為p型半導(dǎo)體。
※9 離子注入:離子注入是一種向半導(dǎo)體中添加雜質(zhì)的技術(shù)。其原理是將雜質(zhì)原子離子化后,通過(guò)數(shù)十千伏(kV)至數(shù)百千伏的高電壓加速注入到半導(dǎo)體材料中。
※10 活性化熱處理:通過(guò)高溫處理修復(fù)離子注入過(guò)程中半導(dǎo)體材料受到的損傷,并促進(jìn)注入雜質(zhì)的電學(xué)活性的工藝。通常使用的溫度為 600°C 至 1200°C。
※11 鰭式結(jié)構(gòu)(FinFET):鰭式結(jié)構(gòu)是指柵極位于溝道的兩側(cè)或包裹溝道,形成雙柵極或多柵極結(jié)構(gòu)的溝道部分設(shè)計(jì)。由于其形狀類(lèi)似于魚(yú)鰭,因此被稱為“鰭式結(jié)構(gòu)”。
※12 亞閾值系數(shù):亞閾值系數(shù)是衡量晶體管關(guān)斷性能的指標(biāo),表示漏極電流增加一個(gè)數(shù)量級(jí)所需的柵極電壓變化量。亞閾值系數(shù)會(huì)因 MOS 界面質(zhì)量的下降而增加(即性能劣化)。
本文轉(zhuǎn)發(fā)自《亞洲氧化鎵聯(lián)盟》訂閱號(hào)
